据外媒报道,华为近期已申请一项“四芯片”(quad-chiplet)封装设计专利,可能用于下一代AI芯片昇腾910D。报道称,这项“四芯片”设计与NVIDIA Rubin Ultra的架构相似,但华为似乎在开发自有先进封装技术。
依据国家知识产权局信息,华为于2023年提交了一项名为 “一种集成装置、通信芯片和通信设备” 的专利。
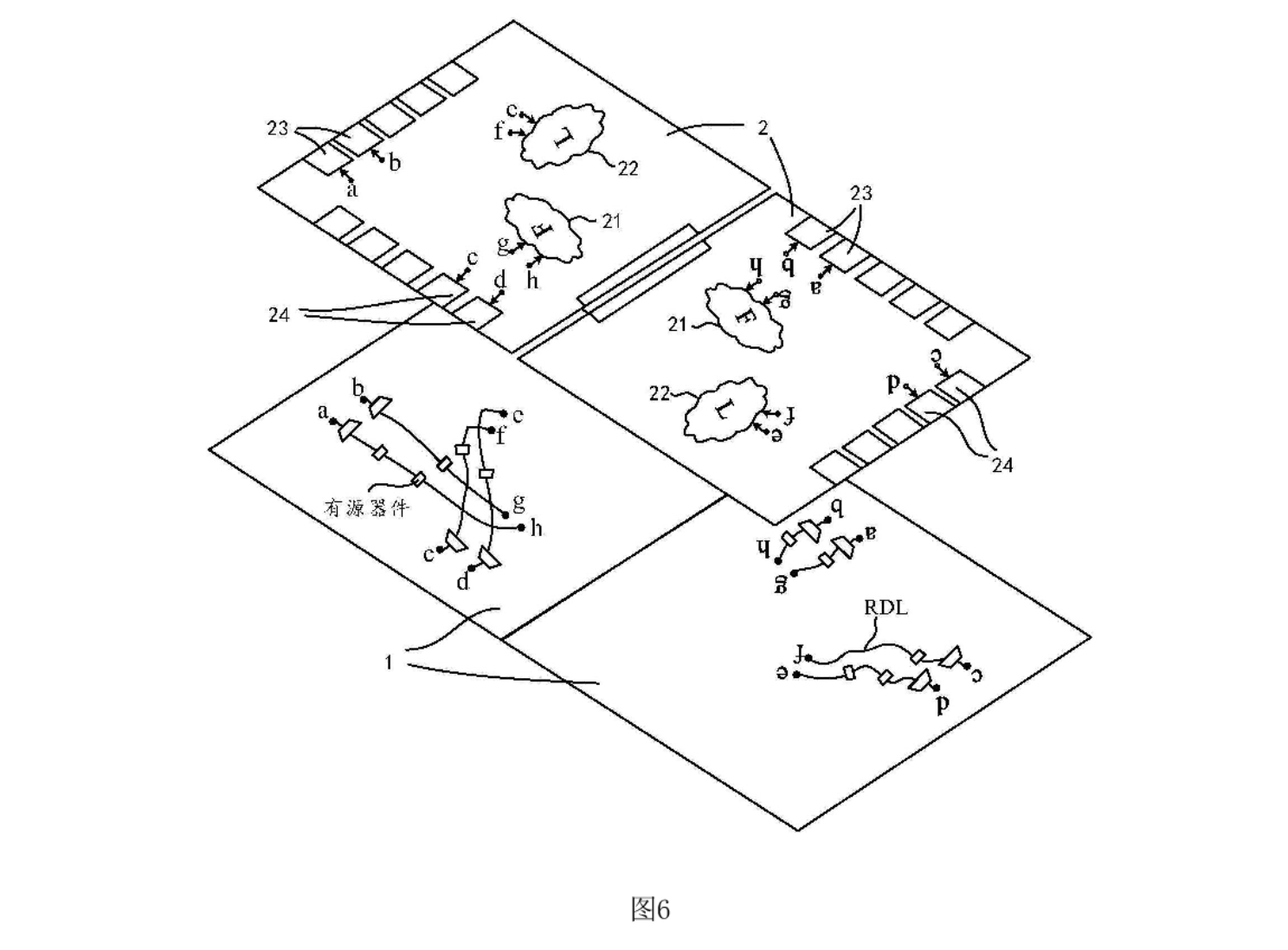

专利内容显示,该专利类似桥接技术(如台积电CoWoS-L),而非单纯中间层的技术。具体而言,其专利展示了一种基于硅中介层的四芯片堆叠方案,借助垂直互连技术实现了芯片之间的超高速数据传输,能够在一个封装内集成四颗计算芯片。
外媒称,为了满足AI训练处理器需求,芯片预期搭配多组HBM,通过中间层互连。
值得关注的是,日前,任正非接受《人民日报》采访时表示,芯片问题其实没必要担心,用叠加和集群等方法,计算结果上与最先进水平是相当的。英伟达的CEO黄仁勋还解读称,任正非的意思是,中国可以用更多的芯片解决发展人工智能的问题。



